FE-5000
OTSUKA大冢-分光器
 除能够进行高精度薄膜解析的分光光导仪外,通过安装测定角度的自动可变机构,也 适用于所有种类的薄膜.。除传统的旋转光子法外,还设置了相位差版的自动解吸机 构,提高了测量精度.
除能够进行高精度薄膜解析的分光光导仪外,通过安装测定角度的自动可变机构,也 适用于所有种类的薄膜.。除传统的旋转光子法外,还设置了相位差版的自动解吸机 构,提高了测量精度.
OTSUKA大冢-分光器FE-5000OTSUKA大冢-分光器FE-5000OTSUKA大冢-分光器FE-5000OTSUKA大冢-分光器FE-5000OTSUKA大冢-分光器FE-5000
特长。
在紫外可见(250到800 nm)波长范围内进行光导参数测量。
纳米计量器等级的多层薄膜的膜厚分析是可能的。
能够通过400ch以上的多通道分光法快速测定光导频谱。
反射角可变测量可实现更详细的薄膜分析。
通过光学常数的数据库化以及**登录功能的追加,提高操作性。
通过层膜拟合解析的光学常数测定,可以进行膜厚·膜质管理。
测量项目。
光导参数(tanψ、cosΔ)测量。
光学常数(n:折射率,k:衰退系数)分析。
膜厚的解析。
用途。
半导体晶圆。
栅氧化薄膜。
SiO2、SixOy、SiN、SiON、SiNx、Al2O3、SiNxOy、poly-Si、ZnSe、BPSG、TiN。
光刻胶的光学常数(波长分散)。
化合物半导体。
AlxGa(1-x)As多层膜,非晶硅。
FPD。
取向膜。
等离子体显示器的ITO,MgO等。
各种新素材。
DLC(Diamond Like Carbon),超导用薄膜,磁头薄膜。
光学薄膜。
TiO2、SiO2、多层膜、防反射膜、反射膜。
光刻领域。
g射线(436nm),h线(405nm),i线(365nm),KrF(248nm)等各波长的n,k评价
仕 様
|
型式
|
FE-5000S
|
FE-5000
|
|
測定サンプル
|
反射測定サンプル
|
|
サンプルサイズ
|
100x100mm
|
200x200mm
|
|
測定方式
|
回転検光子法*1
|
|
測定膜厚範囲(nd)
|
0.1nm~
|
|
入射(反射)角度範囲
|
45~90°
|
45~90°
|
|
入射(反射)角度駆動方式
|
自動サインバー駆動方式
|
|
入射スポット径*2
|
約φ2.0
|
約φ1.2sup*3
|
|
tanψ測定正確さ
|
±0.01以下
|
|
cosΔ測定正確さ
|
±0.01以下
|
|
膜厚の繰り返し再現性
|
0.01%以下*4
|
|
測定波長範囲*5
|
300~800nm
|
250~800nm
|
|
分光検出器
|
ポリクロメータ(PDA、CCD)
|
|
測定用光源
|
高安定キセノンランプ*6
|
|
ステージ駆動方式
|
手動
|
手動/自動
|
|
ローダ対応
|
不可
|
可
|
|
寸法、重量
|
650(W)×400(D)×560(H)mm
約50kg
|
1300(W)×900(D)×1750(H)mm
約350kg*7
|
|
ソフトウェア
|
|
解析
|
*小二乗薄膜解析(屈折率モデル関数、Cauchy分散式モデル式、nk-Cauchy分散式モデル解析など)
理論式解析(バルク表面nk解析、角度依存同時解析)
|
*1 偏光子駆動可能、不感帯に有効な位相差板着脱可能です。
*2 短軸・角度により異なります。
*3 微小スポット対応(オプション)
*4 VLSIスタンダードSiO2膜(100nm)を用いた場合の値です。
*5 この波長範囲内で選択可能です。
*6 測定波長により光源が異なります。
*7 自動ステージ選択時の値です。
原 理
試料にs波とp波を含む直線偏光を入射し、その反射光の楕円偏光を測定します。s波とp波は位相と振幅が独立に変化して、試料に依存した2種類の偏光の変換パラメータであるp波とs波の反射率の比tanψおよび位相差Δが得られます。
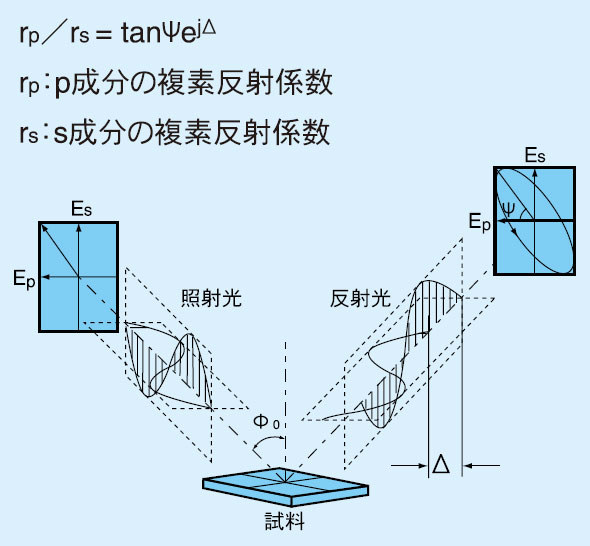
tanψ、consΔはエリプソパラメータと呼ばれており、分光エリプソメトリーではこの2つのパラメータの波長依存スペクトルが測定されます。