详情介绍
FE-300
OTSUKA大冢-膜厚监视器

是一种通过简单操作实现高精度光干涉法的膜厚测量的小型低价格的膜厚计。
采用将必要的机器收纳在机身部位的一体化体型外壳,实现了稳定的数据的获取
通过获取低价位的优良反射率,也可以进行光学常数的分析。
OTSUKA大冢-膜厚监视器FE-300OTSUKA大冢-膜厚监视器FE-300OTSUKA大冢-膜厚监视器FE-300OTSUKA大冢-膜厚监视器FE-300OTSUKA大冢-膜厚监视器FE-300
特长。
支持从薄膜到厚膜的广泛膜厚。
使用反射光谱的膜厚分析。
紧凑、低价位,但不接触、非破坏,实现高精度测量。
条件设定和测量操作简单!任何人都可以轻松进行膜厚测量。
通过非线性*小二乘法、优化法、PV法、FFT分析法等可进行广泛种类的膜厚测量。
非线性*小二乘法的膜厚分析算法使光学常数分析(n:折射率,k:衰退计数)成为可能。
测量项目。
优良的反射率测量。
膜厚分析(10层)。
光学常数分析(n:折射率,k:衰退计数)。
用途。
功能性薄膜、塑料。
透明导电膜(ITO、银纳米线)、相差膜、偏振膜、AR膜、PET、PEN、TAC、PP、PC、PE、PVA、粘合剂、保护膜、外壳。防指纹剂。
半导体。
化合物半导体、Si、氧化膜、氮化膜、Resist、SiC、GaAs、GaN、InP、InGaAs、SOI、Sapphire等。
表面的处理。
DLC涂层、防锈剂、防阴剂等。
光学材料。
过滤器、AR外套等。
FPD。
LCD(CF、ITO、LC、PI)、OLED(有机膜、密封剂,等等)。
其他。
硬盘、磁带、建材等
仕 様
|
型式
|
FE-300V
|
FE-300UV
|
FE-300NIR*1
|
|
全体
|
標準測定タイプ
|
薄膜測定タイプ
|
厚膜測定タイプ
|
厚膜測定タイプ
(高分解能)
|
|
サンプルサイズ
|
*大8インチウェハ(厚さ5mm)
|
測定膜厚範囲
(nd)
|
100nm~40μm
|
10nm~20μm
|
3μm~300μm
|
15μm~1.5mm
|
|
測定波長範囲
|
450nm~780nm
|
300nm~800nm
|
900nm~1600nm
|
1470nm~1600nm
|
|
膜厚精度
|
±0.2nm以内*2
|
±0.2nm以内*2
|
-
|
-
|
|
繰り返し精度
|
0.1nm以内*3
|
0.1nm以内*3
|
-
|
-
|
|
測定時間
|
0.1s~10s以内
|
|
スポット径
|
約φ3mm
|
|
光源
|
ハロゲン
|
重水素とハロゲンの混合
|
ハロゲン
|
ハロゲン
|
|
インターフェイス
|
USB
|
|
寸法、重量
|
<280(W)×570(D)×350(H)mm、約24kg
|
|
ソフトウェア
|
|
|
|
|
|
標準
|
ピークバレイ解析、FFT解析、*適化法解析、*小二乗法解析
|
|
オプション
|
材料評価ソフトウェア、ポスト解析ソフトウェア、膜モデル解析、リファレンスプレート
|
*1 詳細はお問合せください
*2 VLSI社製膜厚スタンダード(100nm SiO2/Si)の膜厚保証書記載の測定保証値範囲に対して
*3 VLSI社製膜厚スタンダード(100nm SiO2/Si)の同一ポイント繰り返し測定時における拡張不確かさ(包括係数 2.1)
測定原理
大塚電子では、光干渉法と自社製高精度分光光度計により、非接触・非破壊かつ高速高精度な膜厚測定を可能にしています。光干渉法は、図2のような分光光度計を利用した光学系によって得られた反射率を用いて光学的膜厚を求める方法です。図1のように金属基板上にコーティングされた膜を例にとると、対象サンプル上方から入射した光は膜の表面で反射します(R1)。さらに膜を透過した光が基板(金属)や膜界面で反射します(R2)。このときの光路差による位相のずれによって起こる光干渉現象を測定し、得られた反射スペクトルと屈折率から膜厚を演算する方法を光干渉法と呼びます。解析手法は、ピークバレイ法、周波数解析法、非線形*小二乗法、*適化法の4種類があります。
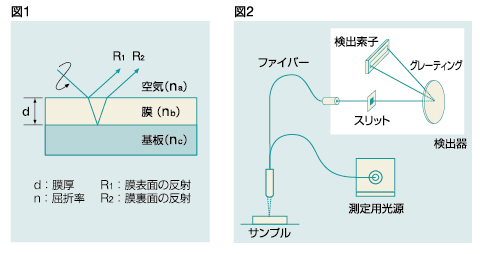
相关产品
产品留言
如果您对该产品感兴趣的话,可以
产品名称: OTSUKA大冢-膜厚监视器FE-300
产品型号:
产品展商: OTSUKA大塚电子
产品文档: 无相关文档
简单介绍
OTSUKA大冢-膜厚监视器FE-300
的详细介绍